

薄膜沉积(如CVD/ALD)是半导体制造的核心工艺之一,需定期使用NF₃清洁腔室以去除沉积物。精确控制清洁终点至关重要:

传统方法依赖经验时间控制,但实际最佳清洁时间受沉积厚度、温度、压力等因素影响,且参数可能漂移。因此,多数工艺会延长清洁时间以确保彻底清洁,但造成资源浪费。Johnson等(2004)提出通过监测SiF₄分压确定清洁终点。红外气体传感器因其高实时性和可靠性,已成为主流检测手段。
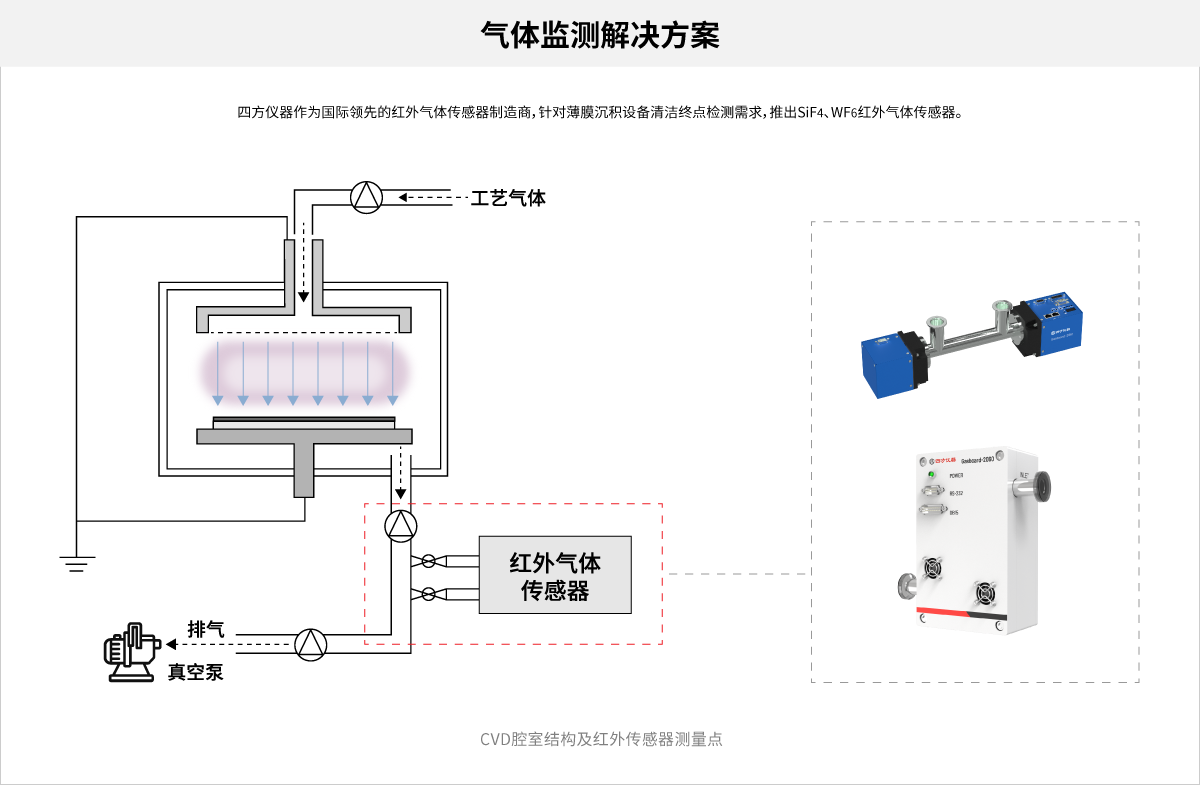
在半导体制造过程中,氧污染会引发不必要的氧化反应,导致集成电路和硅片产生缺陷,进而破坏薄膜结构的完整性,严重影响产品的均匀性与可靠性。因此,半导体制造商必须对工艺气体及设备腔室中的氧含量进行严格监控,即便是微量氧气(低至ppm级)也可能显著损害元件性能。


 在线
在线 咨询
咨询 关注
关注